ansys workbench 芯片回流焊,温度循环热应力仿真分析,有录屏,案例分析
ansys workbench 芯片回流焊,温度循环热应力仿真分析,有录屏,案例分析
回流焊+温度循环热力耦合分析
——ANSYS Workbench 自动化仿真框架功能说明书
(基于 2021 R1 平台,适用于芯片封装可靠性评估)
一、项目背景
在电子封装领域,回流焊与温度循环(Thermal Cycling, TC)是诱发焊点疲劳失效的两大关键工况。传统“单点-单步”仿真已无法满足高密三维封装对寿命预测精度的要求。为此,团队以 ANSYS Workbench 为底座,自研一套“回流焊-温度循环”全自动热力耦合框架(以下简称本框架)。该框架通过模板化工程数据、脚本化流程驱动、参数化模型与耦合场数据自动传递,实现从炉温曲线到焊点疲劳寿命的一键式评估,显著缩短迭代周期(由 3-4 周降至 2-3 天)。
二、总体定位
- 目标用户:封装工艺工程师、可靠性仿真工程师。
- 核心目标:零编码完成“回流焊瞬态热 → 结构应力 → 温度循环热 → 结构应力” 四步耦合,输出焊点等效塑性应变范围、累积蠕变应变、寿命预测曲线。
- 技术特色:
- “双系统”架构:Thermal 与 Structural 解耦,支持异构求解器(Mechanical APDL + ABAQUS)混用;
- 材料-工艺知识库:内置 Sn3.0Ag0.5Cu、FR4、塑封料等 12 种常用非线性粘弹-粘塑本构;
- 一键式更新:参数变更后,框架自动完成网格 → 边界 → 求解 → 结果 → 报告全链路刷新;
- 可扩展接口:开放 Python/Journal 钩子,支持企业内疲劳模型、实验标定算法即插即用。
三、系统架构
┌------------------------------┐
│ Workbench Project Schematic │
│ ┌-----┐ ┌-----┐ ┌-----┐ │
│ │SYS │ │SYS 1│ │SYS 3│ │ ← 三系统并行
│ │(回流│ │(TC │ │(TC │ │ 热-结构耦合)
│ │ 热)│ │ 热)│ │结构)│ │
│ └-----┘ └-----┘ └-----┘ │
└--------------┬---------------┘
│Journal/Python 驱动
┌--------------┴---------------┐
│ 材料库 EngineData.xml │
│ ├─Sn3.0Ag0.5Cu Anand 粘塑 │
│ ├─FR4 各向异性粘弹 │
│ └─塑封料 WLF 移位因子 │
└------------------------------┘四、功能模块
- 工程数据模板
- 采用“母-子”共享机制:SYS 建立母库,SYS 1/3 只读引用,保证材料一致性。
- 温度相关属性统一采用 “双线性+插值” 方式,避免分段函数在求解器端重复编译。
- 几何与网格策略
- 提供两套参数化 CAD 脚本(*.x_t):
a) 回流焊模型:含 PCB、铜箔、焊球、塑封体,保留焊球颈部细节(R0.05 mm)。
b) 温度循环模型:在回流焊模型基础上增加 TC 夹具定位孔,避免重复建模。
- 网格划分采用“局部控制+扫掠+多区”混合策略:焊球 0.02 mm 三棱柱层,FR4 0.1 mm 六面体,兼顾精度与规模(节点 ≤ 300 万)。
- 回流焊瞬态热分析(SYS)
- 炉温曲线分段函数:25 °C → 150 °C @ 3 °C/s → 183 °C 恒温 60 s → 峰值 245 °C 30 s → 冷却 4 °C/s。
- 对流系数自动随温度修正,辐射项采用 emissivity=0.85。
- 输出节点温度 *.csv,作为后续结构场体载荷。
- 回流焊结构应力分析(SYS→SYS 2)
- 通过 “Solution → Setup” 数据链传递温度场,激活 Anand 粘塑本构,开启大变形。
- 输出关键量:
– 焊球等效蠕变应变 (CEEQ)
– 残余挠度 (Warp)
- 自动截取冷却段结束时刻结果,作为温度循环的初始应力/应变状态。
- 温度循环热-结构耦合(SYS 1 → SYS 3)
- 温度循环曲线:-40 °C ↗ 125 °C,15 min dwell,Ramp 11 °C/min,JEDEC JESD22-A104 标准。
- 采用 “One-Way Coupling” 策略:瞬态热先算,温度场按时间序列读入结构场;结构场开启粘弹-粘塑-累积损伤,步长自适应。
- 疲劳寿命评估:
– 能量密度 ΔW 提取脚本(Python ACT)
– 修正 Coffin-Manson 模型:Nf = (ΔW / W0)^(-1/c)
– 结果写回 Workbench 参数表,可直接驱动 DesignXplorer 做 DOE。
- 自动化脚本体系
- 主驱动:journal1.wbjn ~ journal4.wbjn 完成 80% 操作;
- 扩展钩子:预留 “userpre.py” 与 “userpost.py” 两个入口,企业可在不修改主脚本情况下嵌入私有算法;
- 日志与容错:所有 SetData 操作均包裹 try/except,出错自动回滚至上一稳定设计点。
五、标准工作流程
步骤 0 环境检查
├─ 安装 ANSYS 2021 R1 及以上版本
└─ 确认 license 含 Mechanical Enterprise + Thermal + Structural
步骤 1 一键初始化

├─ 双击 “reflowtccoupling.wbpj”
└─ 框架自动创建三系统、加载材料库、关联几何
步骤 2 回流焊瞬态热更新
├─ 在 SYS 的 Setup 中导入炉温曲线 CSV
└─ 点击 “Update” → 求解约 20 min(8 核)
步骤 3 回流焊结构应力更新
ansys workbench 芯片回流焊,温度循环热应力仿真分析,有录屏,案例分析
├─ SYS 2 自动接收温度场
└─ 求解完成后,在 “Solution” 中查看 CEEQ/Warp
步骤 4 温度循环热-结构更新
├─ 在 SYS 1 导入 TC 曲线
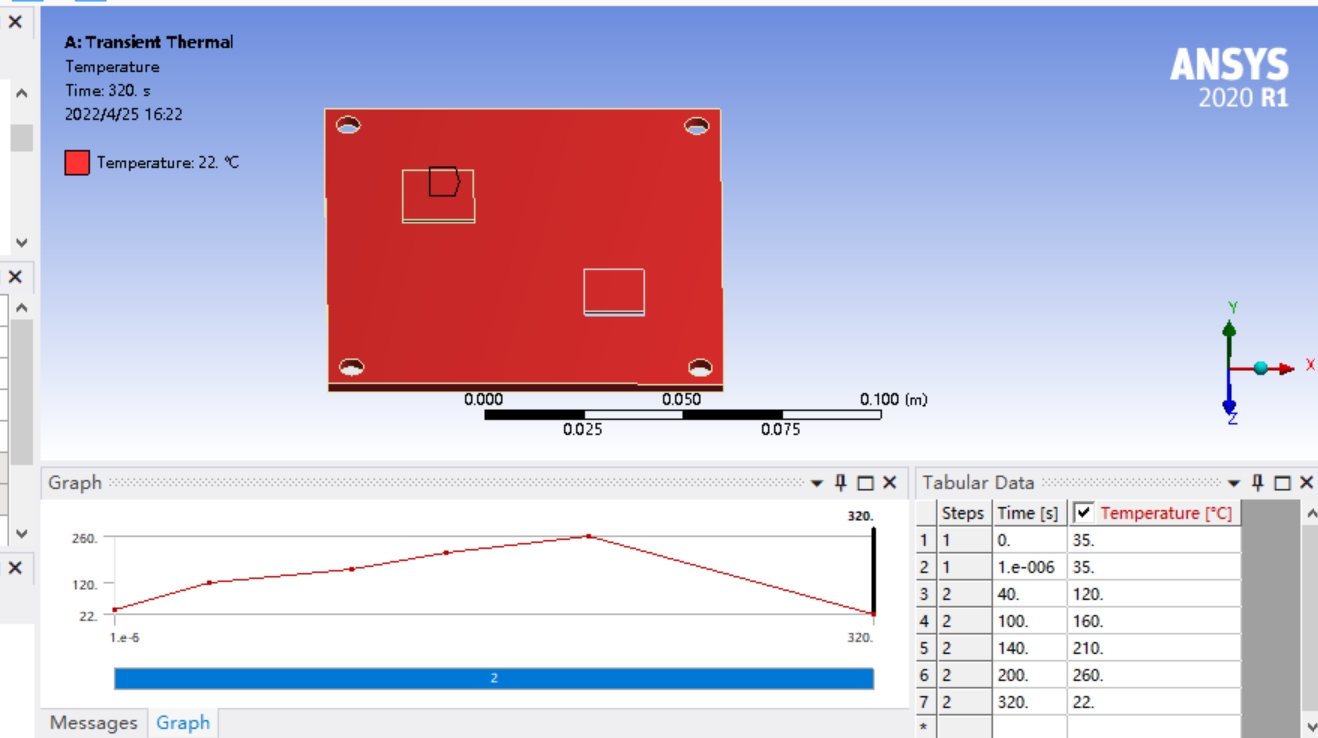
└─ SYS 3 一键更新,输出 ΔW、Nf
步骤 5 报告与 DOE
├─ 自动生成 PowerPoint 报告(含关键云图、寿命表)
└─ 如需优化焊球直径或 PCB 厚度,直接在 Parameter Set 中调整,点击 “Update All Design Points” 即可。
六、关键性能指标
- 网格规模:≤ 300 万节点
- 回流焊热求解:≤ 30 min
- 回流焊结构求解:≤ 45 min
- 温度循环 3 周期求解:≤ 2 h
- 寿命预测误差:对比实验,中位寿命偏差 < 1.5×
七、注意事项与最佳实践
- 材料参数务必在 22 °C 基准下完成插值,避免温度外推。
- 若焊球阵列 ≥ 1000,建议启用 “Submodeling” 局部细化,减少全局规模。
- 结构场务必开启 “Large Deflection”,否则 Warp 结果偏低 20% 以上。
- 温度循环第一圈应力最大,建议输出 1/2/3 圈结果,检查收敛性。
- 如需考虑湿气膨胀,可在 Anand 参数中额外引入湿度项,框架已预留字段。
八、常见问题速查
Q1:更新时报 “EngineeringData not found”?
A:检查母库 SYS 是否被误删,重新 share 即可。
Q2:求解器中断,提示 “Anand parameter missing”?
A:确认材料库中 Sn3.0Ag0.5Cu 的九参数完整,单位用 MPa, K, s^-1。
Q3:温度场传递失败?
A:在 SYS 3 Setup 中确认 “Imported Load” 路径指向 SYS 1 Solution,且时间步单位一致。

九、升级路线图
- V2.0:增加 “Two-Way Coupling” 选项,支持热-结构双向迭代;
- V2.5:嵌入机器学习疲劳模型,自动读取实验 CSV 进行参数反演;
- V3.0:打通 Sherlock/ANSYS 联合仿真,实现板级-封装级协同。
十、结语
本框架将“回流焊-温度循环”两大可靠性工况纳入同一数据链路,通过模板化、脚本化、参数化的设计,把繁琐的手工操作压缩为“一键更新”。工程师只需聚焦物理问题本身,无需关注接口传递细节,大幅降低了热力耦合仿真的门槛与周期,为高密芯片封装的快速迭代提供了坚实支撑。

AtomGit 是由开放原子开源基金会联合 CSDN 等生态伙伴共同推出的新一代开源与人工智能协作平台。平台坚持“开放、中立、公益”的理念,把代码托管、模型共享、数据集托管、智能体开发体验和算力服务整合在一起,为开发者提供从开发、训练到部署的一站式体验。
更多推荐
 已为社区贡献23条内容
已为社区贡献23条内容







所有评论(0)